Copper Deposition in a Through-Hole Via
Application ID: 97901
This model demonstrates the "butterfly" filling mechanism for copper electrodeposition in a Through-Hole (TH) via exposed to an electrolyte containing halide-suppressor additives.
The Tertiary Current Distribution, Nernst Planck interface in combination with Deformed Geometry is used to track the moving boundary at the cathode surface. The model accounts for adsorption/desorption of additives using dissolving-depositing species formulation.
The model results show selective copper electrodeposition at the middle of the TH, in order to achieve void-free deposition.
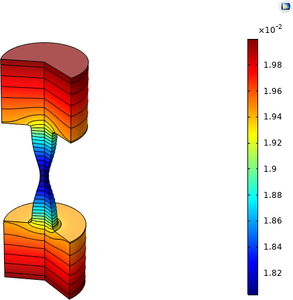
This model example illustrates applications of this type that would nominally be built using the following products:
however, additional products may be required to completely define and model it. Furthermore, this example may also be defined and modeled using components from the following product combinations:
- COMSOL Multiphysics® and
- either the Battery Design Module, Corrosion Module, or Electrodeposition Module
The combination of COMSOL® products required to model your application depends on several factors and may include boundary conditions, material properties, physics interfaces, and part libraries. Particular functionality may be common to several products. To determine the right combination of products for your modeling needs, review the Specification Chart and make use of a free evaluation license. The COMSOL Sales and Support teams are available for answering any questions you may have regarding this.



